关于SiP芯片封装的市场分析:SiP芯片封装介绍|惟道研究
半导体封装技术发展历程悠久,随着电子产品小型化、轻量化和高性能的发展需求,芯片封装行业也逐渐向高密度、高脚位、薄型化和小型化的方向发展,先进封装变成现在半导体封装领域的主要发展方向之一,市场需求稳定增长,未来发展前景广阔。本篇,我们从SiP系统级封装着手,对其技术、优缺点进行介绍,分析其产业链上下游。
来源:中融研究作者:惟道风险研究院

(一)封装行业背景
芯片封装,顾名思义是对芯片安装外壳,以起到安放、固定、密封、保护芯片和增强电热性能的作用。从狭义上来说,芯片封装是一种利用一系列技术,将芯片在框架上进行布局、粘贴、固定及连接,引出接线端并通过可塑性绝缘介质灌封固定,构成整体立体结构的工艺。芯片封装也是沟通芯片内外部电路的桥梁,芯片上的接点用导线连接到封装外壳的引脚上,这些引脚又通过印制板上的导线与其他器件建立连接。
1. 芯片封装的重要性
芯片封装对于芯片行业意义重大,从芯片本身来看,芯片尺寸微小,且厚度较薄,如果不在外对芯片施加保护,一方面会使得芯片被轻易刮伤损坏,另一方面也会使得芯片不易被人工安置在电路板等上面。而封装正可以起到安放、固定、密封等作用,对集成电路起着重要作用。
物理保护作用。一般情况下,半导体芯片生产条件及其严格,其生产车间通常都有非常严格的生产条件控制,恒定的温度、恒定的湿度、严格的空气尘埃颗粒度控制及严格的静电保护措施,裸露在外的芯片只有在这种严格的环境控制下才不会失效。然而,我们的日常环境并不能具备这些条件,气温变化大,湿度大,同时还有各类外界杂质、静电等问题会侵扰脆弱的芯片。而封装即使可以使得芯片与外界隔离,防止空气中的杂质对芯片造成损害。
支撑连接作用。芯片封装技术可以起到支撑和连接的作用。首先,封装外壳可以支撑固定芯片,便于电路的连接,封装后形成的外形也可以支撑整个器件,使得整个器件不易损坏。其次,利用封装技术可以将芯片的电极与外界的电路进行连通,封装中的引脚用于和外界电路连通,金线则将引脚和芯片的电路连接起来,载片台用于承载芯片,环氧树脂粘合剂用于将芯片粘贴在载片台上。此外,封装技术也可以实现多个IC互联,例如使用引线键合技术等标准的互连技术来直接进行互连,也可以利用封装提供的互连通路,如多芯片组件(MCM)、系统级封装(SIP)以及更广泛的系统体积小型化和互连(VSMI)概念所包含的其他方法中使用的互连通路,来间接地进行互连。
增强散热作用。半导体产品在工作时会产生热量,这些热量达到一定限度后会影响芯片的正常工作。而封装可以增强芯片散热效果,一方面,封装的材料本身就可以带走一份热量,另一方面,芯片封装时一般会额外安装金属散热片或风扇,以达到更好的散热效果。
2. 芯片封装的发展历程
半导体封装技术发展历程悠久,随着电子产品小型化、轻量化和高性能的发展需求,未来封装技术的发展趋势也一定是向高密度、高脚位、薄型化和小型化的方向发展。目前,半导体封装行业的发展大致可以分为以下五个阶段。
第一阶段:20世纪70年代以前的通孔插装时代。封装技术是以DIP为代表的针脚插装, 特点是插孔安装到PCB板上,最早的DIP包装原件是由仙童半导体司在1964年发明。DIP的特点是在裸露的芯片周围使用塑料封装外壳,同时有两排平行的突出的引脚,即引线框架,用于与印制电路板相连。然而,这种技术密度、频率难以提高,无法满足高效自动化生产的要求。
第二阶段:20世纪80年代以后的表面贴装时代。这一时代封装技术已从DIP转向表面贴装技术(SMT),这种技术用引线替代第一阶段的引脚,并贴装到PCB板上,以SOP和QFP为代表。与DIP相比,这种技术封装密度有所提高,体积有所减少。
第三阶段:20 世纪 90 年代以后的面积阵列封装时代,广泛使用的球栅阵列封装开始发展。该阶段出现了BGA、CSP、WLP为代表的先进封装技术,第二阶段的引线被取消。这种技术在缩减体积的同时提高了系统性能。
第四阶段:20世纪末开始的现代封装时代。在这一阶段,虽然前三阶段的相关封装技术仍在使用中,但是受半导体速度需求的增加,越来越多的封装类型开始出现,如多芯片组件(MCM)、三维立体封装(3D)、系统级封装(SiP)等。
第五阶段:21世纪以来,全球半导体市场开始缓慢进入“先进封装”半导体时代。这一阶段主要是系统级单芯片封装(SoC)、微机电机械系统封装(MEMS)等。
表1 集成电路封装技术的五个发展阶段

资料来源:国信证券,惟道风险研究院整理
然而,虽然封装技术发展至今已有五个阶段,且先进封装的技术层出不穷,看似为半导体封装行业带来了无限前景,然而受到无法规模化量产等限制,目前全球半导体封装的主流正处在第三阶段的成熟期和快速发展期,以CSP、BGA、WLP等主要封装形式进入大规模生产时期,同时部分产品已开始向第四阶段发展,以SiP和MCM为主要发展方向的第四次技术变革处于孕育阶段。
(二)SiP芯片封装技术介绍
SiP封装(System In a Package系统级封装)是一种新型封装技术,它将多种功能晶圆,包括处理器、存储器等功能晶圆根据应用场景、封装基板层数等因素,集成在一个封装内,从而实现一个基本完整功能的封装方案。
SiP封装采用多重裸芯片或模块进行排列组装,并无一定形态,就排列方式而言可以分为平面式2D封装和3D封装结构。与平面式2D封装相比,采用堆叠的3D封装技术可以增加使用晶圆或模块的数量,从而在垂直方向上增加了可放置晶圆的层数,可以进一步增强SiP技术的功能整合能力,有效缩减封装面积。从内部接合技术方面可以将SiP封装分为单纯的线接合(Wire Bonding)和倒装芯片(Flip Chip)两类,但也可以进行二者混用。
图1 SiP封装技术示意图
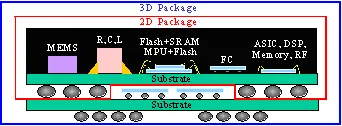
SiP与SOC(系统级芯片)相对应,不同的是SiP采用不同芯片并排或叠加的封装方式,是分批设计、分阶段制造的。而SOC则是高度集成的芯片产品,是一体设计,一体制造,是一个有专用目标的集成电路。SiP是从封装的立场出发,对不同芯片进行并排或叠加的封装方式,将多个具有不同功能的有源电子元件与可选无源器件,以及诸如微机电系统(MEMS)或者光学器件等其他器件优先组装到一起实现一定功能的单个标准封装件。
图2 SiP封装技术示意图
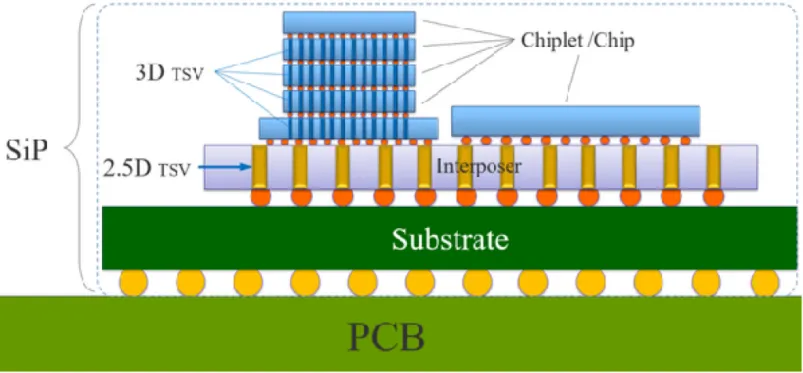
从市场情况上看,SiP主要应用在消费电子、无线通信、汽车电子等领域。近年来,随着SiP模块成本的降低、效率的提升,以及制造流程趋于成熟,采用这种封装方式的应用领域逐渐渗透拓展至工业控制、智能汽车、云计算、医疗电子等诸多新兴领域。
(三)SiP技术优缺点
SiP属于二次开发。它是在已制成的半导体芯片基础上,加入更多芯片或辅助零件,使之成为一个功能更复杂或性能更完善的半导体产品,其降低了大型复杂芯片的设计和制造门槛,缩短了系统级芯片的开发周期,加速了系统级芯片的发展进程,为系统级芯片的多样性提供了极大的便利,有着封装效率高、兼容性好、稳定性好等亮点。
表2 SiP封装的优势

资料来源:半导体行业观察,天风证券,惟道风险研究院整理
(四)SiP技术产业链
1. 半导体封装材料产业链
SiP封装技术属于半导体封装行业的一部分。在半导体封装产业链中,上游为金属、陶瓷、塑料、玻璃等各种原料,下游为半导体广泛的应用领域。
产业链上游为原材料,主要包括:
(1)铜材:以纯铜或铜合金制成各种形状包括棒、线等统称铜材。
(2)铝材:铝材由铝和其他合金元素制造的制品。通常是先加工成铸造品、锻造品以及箔、板、带、管、棒、型材等后,再经冷弯、锯切、钻孔、拼装、上色等工序而制成。
(3)玻璃材料:平板玻璃也称白片玻璃或净片玻璃,其化学成分一般属于钠钙硅酸盐玻璃。按照生产工艺的区别,平板玻璃可分为浮法玻璃和压延玻璃,其中浮法玻璃下游需求主要分布在房地产(占比70%)和汽车制造(占比20%)领域;压延玻璃需求集中在光伏领域。
(4)塑料材料:塑料是以单体为原料,由合成树脂及填料、增塑剂、稳定剂、润滑剂、色料等添加剂组成,可以用来做包装材料。
产业链中游即为封装阶段。封装是将芯片在基板上布局、固定及连接,并用可塑性绝缘介质灌封形成电子产品的过程,目的是保护芯片免受损伤,保证芯片的散热性能,以及实现电能和电信号的传输,确保系统正常工作;封装体主要是提供一个引线的接口,内部电性讯号可通过引脚将芯片连接到系统,并避免芯片受到外力、水、湿气、化学物等的破坏和腐蚀等。
产业链下游主要包括智能终端,汽车电子,新能源汽车,节能环保,信息安全和消费电子等科技领域。近年来,随着封装产业链下游科技的不断发展,封装材料市场也不断发展,半导体封装行业正在步入新的发展阶段。
2. SiP封装技术产业链
SiP封装技术属于半导体封装的其中一类,其产业链上游包括锡焊膏、键合丝、引线框架、塑封料、半导体封装设备等,下游广泛应用于通信及智能手机、可穿戴设备、汽车电子等领域。
图3 SiP产业链

资料来源:共研网,惟道风险研究院整理
注:以上内容不作为任何投资或建议,仅供参考。












评论